
最小订购量:1台
常温晶片接合装置BONDMEISTER
开启接合工艺新天地的常温晶片接合装置
两枚晶片在常温下牢固接合……这种梦幻般的接合方式就是通过表面活化实现常温接合。 通过常温(室温)工艺可以获得与母材相当的粘合强度。 由于不会因接合而产生热应变和热应力,因此容易应对小型化,且器件质量稳定。 因为不需要加热/冷却时间,所以可以实现高产量。 可以连接多种材料。此外,可以连接不同的材料。
- 特点
- 高效的生产流程工艺 高粘合强度
产品信息
基本信息
| MWB-04 / 06-R | MWB-04 / 06 / 08-AX | MWB-08 / 12-ST | |
| 产品图片 | 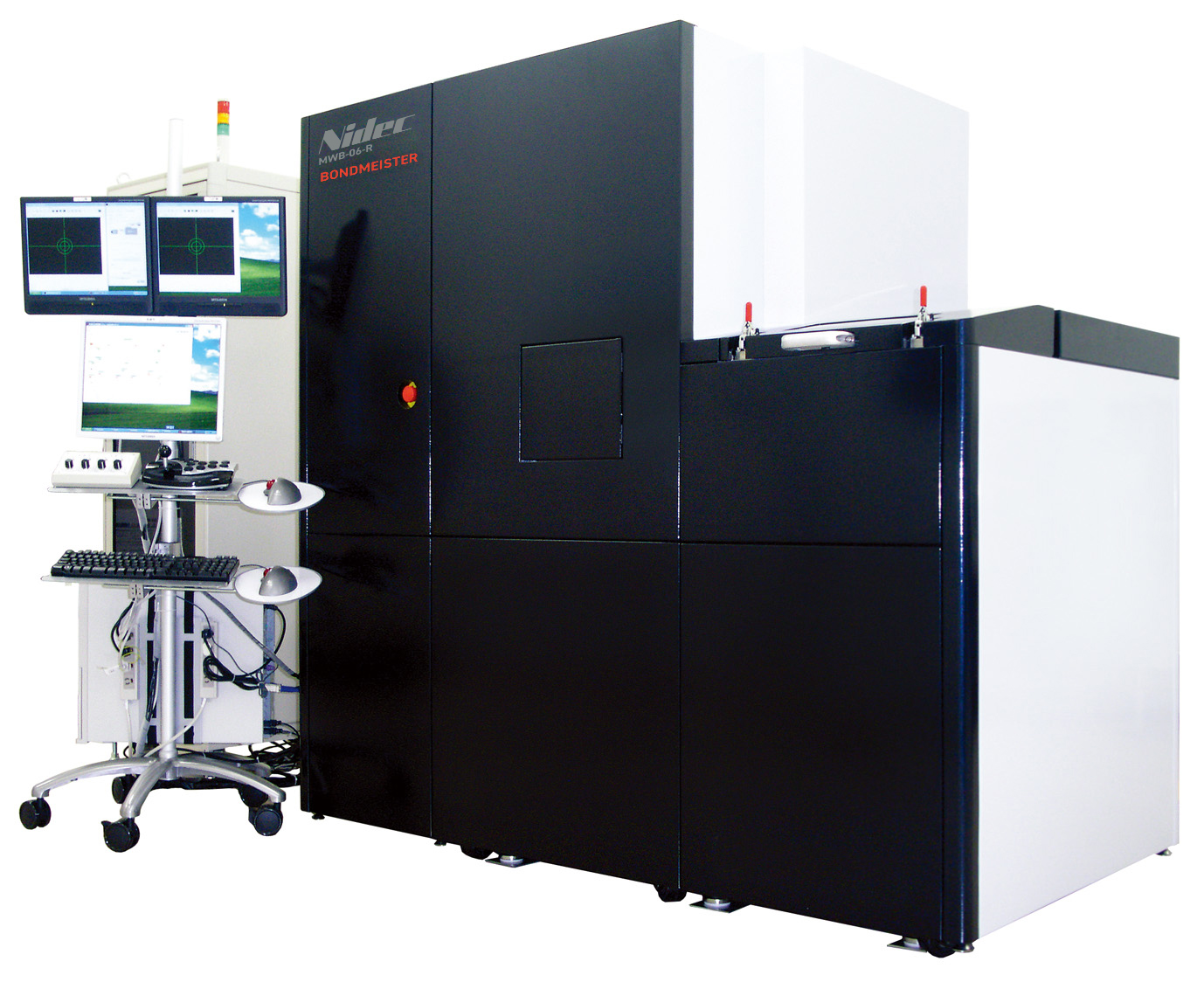 |
 |
 |
| 处理单元 | 1个关节 | 10个关节 | 5套(最多) |
| 晶圆尺寸 | 100mm / 150mm | 100mm / 150mm / 200mm | 300mm / 200mm |
| 驾驶模式 | 半自动 | 全自动/半自动 | 全自动/半自动 |
| 层压精度 | ± 2 μm(我们的实际值(注1)) | ± 2 μm(我们的实际值(注1)) | ± 2 μm(我们的实际值(注1)) |
| 表面活化 | 离子枪 | 离子枪/FAB枪 | 氩快原子束 |
| 压焊机构 | 高达 20kN | 高达 100kN | 最大施加载荷 200kN |
| 结盟 | 红外线透射/反射法 | 红外线透射/反射法 | 红外线透射/反射法 |
| 真空室 | 接合室10-6 Pa 单位 | 接合室10-6 Pa 单位 | 1.0 × 10-5 Pa 单位 |
| 公用事业 | 氩气、氮气、压缩空气 | 氩气、氮气、压缩空气 | 氩气、氮气、压缩空气 |
| 电源(200V、100V) | 电源(200V、100V) | 电源(200V、100V) |
(注 1) 实际值数据并非保证值。
产品特征
常温接合广泛用于以下几类:
引进设备的优势:
客户开发支持系统:
我们通过名为“Bond Mate”的程序,为利用常温接合技术开发器件的客户提供全方位支持。从开发初期的材料检验到量产启动和售后服务提供始终如一的支持。
我们通过分析/设备评估并结合工程师的意见,为客户的开发阶段提供接合技术支持。
如果您联系我们,我们将为您提供目录。
- 晶片级封装
特别对于MEMS和晶体器件,我们可以通过无热变形的封装来提高器件质量并降低成本。 - 功能性晶片的制造
通过接合不同材料的裸晶片,可以制造出各种功能性晶片。 - 直接接合的应用
不使用树脂、合金等中间材料,直接接合,因此器件特性得到改善。
此外,中间材料的成本可以降低到零。 - 晶片堆叠
可以将硅通孔 (TSV) 的晶片多层接合,从而用于制造 3D 集成器件。
不加热,可确保器件的可靠性。
此外,由于没有热变形,可以将器件的内应力降至最低。
引进设备的优势:
- 通过无热变形的接合大大提高了产量。
- 由于可以接合各种类型的材料,因此大大扩展了器件设计的自由度。
- 由于没有热变形,器件可以做得更小更薄,并且可以提高每枚晶片的产量。
- 强接合可最大限度减少接合面积并提高每枚晶片的产量。
- 由于是直接接合,因此无需使用树脂或金属作为中间材料,可以降低成本。
- 无需特殊的实用程序,并且可以将运行成本保持在较低水平。
客户开发支持系统:
我们通过名为“Bond Mate”的程序,为利用常温接合技术开发器件的客户提供全方位支持。从开发初期的材料检验到量产启动和售后服务提供始终如一的支持。
我们通过分析/设备评估并结合工程师的意见,为客户的开发阶段提供接合技术支持。
如果您联系我们,我们将为您提供目录。
产品咨询
关注官方微信公众号,了解更多详情


